后摩尔时代 , 从有源相控阵天线走向天线阵列微系统

本文围绕高分辨率对地微波成像雷达对天线高效率、低剖面和轻量化的迫切需求 , 分析研究了有源阵列天线的特点、现状、趋势和瓶颈技术 , 针对对集成电路后摩尔时代的发展预测 , 提出了天线阵列微系统概念、内涵和若干前沿科学技术问题 , 分析讨论了天线阵列微系统所涉及的微纳尺度下多物理场耦合模型、微波半导体集成电路、混合异构集成、封装及功能材料等关键技术及其解决途径 , 并对天线阵列微系统在下一代微波成像雷达中的应用进行了展望 。


中国高分辨率对地观测系统重大专项是国家下达的一项重大科研项目。高分辨率对地微波成像雷达是高分辨率对地观测系统重大专项重要组成部分。微波成像雷达不仅能提供高分辨率的地面静止目标的结构形状信息 , 而且能实时探测地面、空中或空间的运动目标。微波成像雷达系统能力与目标的电磁特性、天线理论和工程及信号处理技术等密切相关 。
相控阵技术已成为雷达发展的主流,包括高分辨率对地微波成像雷达。为了有效地缓解微波成像雷达高分辨率与宽观测带之间的矛盾,有源阵列天线是理想的选择 , 并且天线的高效率、大孔径、低剖面和轻量化是工程应用的急需 , 也是天线工程师永恒的追求。天线高效率能让天线获得发射、接收双程得益,是星载微波成像雷达优先追求的重要参数;天线大功率孔径积是微波成像雷达的基本要求,天线大孔径是获得雷达大功率孔径积最简洁的方式 ;由于卫星发射受到火箭整流罩包络的限制, 只有较低剖面厚度天线的折叠,才能得到较大的天线孔径;有源阵列天线轻量化是降低发射运载和卫星成本最有效最直接的途径 。
综上所述,高分辨率微波成像雷达的性能参数与有源阵列天线的频率特性、带宽特性和极化特性密切相关,如表 1 所示 . 为了提高天线效率、减小天线阵面尺寸, 采用多波段、多极化共孔径天线技术;为了缓解高分辨率与宽观测带之间的矛盾,提高观测带宽度,采用多通道技术。在高效率、低剖面和轻量化条件下, 实现天线共孔径和多通道等技术,大大地增加有源阵列天线的研究难度,需要从有源阵列天线系统架构层面进行折衷、分析和优化 , 也要从理论和设计方法上进行研究 。

表 1 天线对微波成像雷达性能影响关系分析图片


在集成电路摩尔 (Moore) 时代 , 有源阵列天线技术是集现代相控阵天线理论、半导体技术及光电子技术为一体的高新技术产物 , 例如 , 有源阵列天线中的 T/R 组件、延时放大组件等 . 有源阵列天线有成千上万个 T/R 组件,每个 T/R 组件都是由发射链路中的放大器和接收链路中的低噪声放大器,以及移相器等构成。随着半导体技术的发展, 单片微波集成电路 (monolithic microwave integrated circuit,MMIC) 技术、射频微机械电子系统 (radio frequency microelectro mechanical systems, RF MEMS) 技术和集成封装技术为高性能、高可靠、小型化和低成本 T/R 组件的实现提供了技术途径,尤其是集成电路技术正在从窄带单功能向宽带多功能、从单片集成电路 (monolithic integrated circuit, MIC) 向片上系统 (system on chip, SoC),以及从多芯片组件 (multi-chip module, MCM) 向多功能系统级封装(system in package, SiP) 方向发展,T/R 组件的结构形式由砖块式 (brick) 发展到瓦片式 (tile), 这些都极大地推动有源阵列天线技术的发展 。
有源阵列天线技术在高分辨率微波成像雷达应用时,特别适合多模式快速切换、波束赋型和波束扫描,实现微波成像雷达多种模式工作,使雷达具有快速响应、自适应和故障弱化等能力。根据微波成像雷达的特点和技术的发展,最值得重视的是有源阵列天线以下几个特征 。
2.1 有源阵列天线技术是提升微波成像雷达性能的重要途径
高分辨、多波段、多极化、多平台是合成孔径成像雷达的重要发展方向,有源阵列天线技术在高分辨率成像和多种模式实现上,具有显著的优势 。
不同装载平台的微波成像雷达都非常关注天线孔径与发射平均功率乘积。众所周知,合成孔径雷达的方位分辨率是天线方位向尺寸的一半 ,从这点来看,天线尺寸越小越好,而大天线孔径是降低合成孔径雷达造价的重要途径,人们期望天线尺寸尽可能大,发射功率尽可能低,因此,实现高分辨率和采用大天线孔径是一对矛盾。有源阵列天线有效地缓解了这一矛盾,低分辨率时,可以有效地利用天线大孔径,高分辨率时,通过相位加权展宽天线波束等效缩短天线孔径尺寸 。
有源阵列天线的运用,使星载微波成像雷达扫描成像 (ScanSAR) 模式距离向的观测带宽度、聚束成像 (SpotlightSAR) 模式的波束指向精度都大幅提高。有源阵列天线波束扫描灵活、无惯性和速度快的特点使微波成像雷达能够实现精确运动补偿,保障高分辨率成像的实现,从而提高雷达成像质量 。
2.2 有源阵列天线有利于提高微波成像雷达抗干扰能力
微波成像雷达的目的是获得被选择区域情报信息,对雷达干扰的目的是阻止、混淆、或迟时获得被选择地域的信息。对常规情报或跟踪雷达来说 , 干扰机的有效性一般用雷达作用距离的减小量来度量。对于微波成像雷达 , 干扰机就是阻止一个区域图像信息的侦察,干扰机的有效性,一般用系统灵敏度的降低量来度量 。
雷达抗干扰目的就是减小对雷达的干扰效果,为了提高抗干扰能力,通常采用的如提高雷达有效辐射功率、低或超低副瓣天线、大时宽带宽乘积信号、双 / 多基地雷达系统等方法,这些对提高雷达抗电子干扰能力是至关重要的。对有源阵列天线来说 , 由于空间波束 ( 功率 ) 合成的高效率 , 天线具有高增益、低副瓣电平能力 , 有利于提高天线辐射总功率 ; 由于天线的每个辐射单元的幅度和相位可以独立控制 , 利用空间滤波技术 , 实现天线自适应副瓣置零 , 抑制干扰与杂波 ; 同时 , 也有利于实现辐射能量管理 , 合理使用辐射能量 , 提高雷达抗干扰自卫距离 。
2.3 有源阵列天线有利于实现微波成像雷达的标准化、模块化
对雷达性能要求的提高和雷达工作环境的恶化 , 使雷达系统的构成越来越复杂 , 研制周期加长 , 研制和生产成本上升 , 技术风险增加 . 为适应这种形势 , 有源阵列天线是一条重要的出路。有源阵列天线可采用大量一致的标准组件 ( 例如 T/R 组件、延时放大组件等 ),这利于雷达的标准化、模块化和降低生产成本 。
诚然,有源阵列天线技术是一种会赋予微波成像雷达 “ 新生 ” 的技术,但是,就其技术的本身尚有天线的剖面厚度厚、效率不高和重量较重等诸多难度很大的问题需要解决,这些技术瓶颈必将限制新一代高分辨微波成像雷达技术的发展。随着集成电路技术按照摩尔定律不断纵深发展,微电子、光电子、微机电等基础技术能力得到了快速发展 , 但是进一步向纳米级集成发展的步伐受到技术和成本的约束越来越大 ; 有源阵列天线的发展急需一种新的技术路线来满足微波成像雷达对大孔径、高效率、低剖面和轻量化天线的需求。与此同时 , 随着跨界系统架构和软件算法的兴起 , 跨界融合形成新型能力以满足下一代潜在需求成为创新热点。后摩尔时代的到来 , 需要系统架构技术与微纳电子技术紧密结合和融合创新 , 因此 , 就有源阵列天线而言 , 天线阵列微系统技术是一项多学科交叉的前沿新兴技术 , 将是后摩尔时代的产物 。


3.1 有源阵列天线发展现状
有源阵列天线技术的发展,不断地推动通信、雷达 , 以及个人消费电子等系统小型化、集成化和低功耗。传统的有源阵列天线是砖块式 (brick) 结构,它是由无源天线阵面、多种功能模块与无源天线集成在一起的。针对新一代信息系统的微型化、多功能、高性能、低功耗、低成本等多种需求 , 并随着半导体技术以及先进封装工艺的发展和驱动 , 出现了片上天线 (antenna on chip, AoC) 、封装天线(antenna in package, AiP) 、系统级封装 (SiP) 等新型天线。AoC 和 AiP 分别属于 SoC 和 SiP 概念的范畴。在这几种天线形式之外 , 还出现了瓦片式天线 (tiled antenna)。它们之间的关系如图 1 所示 。
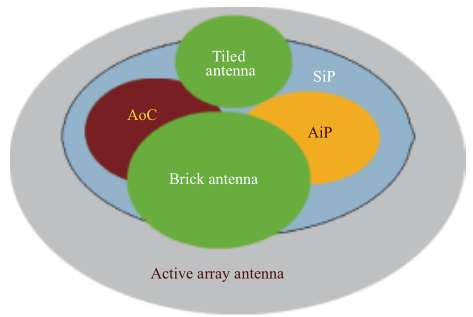
图1 (网络版彩图) 几种有源阵列天线之间的关系示意图
AoC是通过半导体材料与工艺将天线与其他电路集成在同一个芯片上 , 是基于硅基工艺的片上天线。AoC技术可以以更低的系统成本来提高天线的性能和功能 , 但是由于使用相同的材料和工艺,难以使每个类型的电路性能达到最优 , 进而导致天线系统性能难以达到最优。同时 , 由于硅片本身的低电阻率、高介电常数的特性 , 天线辐射时很大一部分能量集中在硅基片内 , 从而天线辐射效率和增益一般都较低。常规硅基工艺的片上天线的增益一般小于−5 dBi,辐射效率只有5%, 甚至更低。采用质子注入 、微机械加工、人工磁导体 ,以及介质透镜等技术 , 在一定程度上提高了天线的增益或辐射效率 。
AiP 是通过封装材料与工艺 , 将天线集成在携带芯片的封装内。封装天线技术继承和发扬了微带天线、多芯片电路模块及瓦片式相控阵天线结构的集成概念 , 将天线触角伸向集成电路、封装与新型材料等领域.相比于AoC,AiP将多种器件与电路集成在一个封装内 , 完成片上天线难以实现的复杂功能和特定的系统级封装 , 有效避免了半导体衬底的低电阻率带来的增益损耗问题 , 天线辐射效率一般达到80%以上。封装形式有芯片直接贴装 (direct chip attach, DCA) 、焊盘阵列封装(land grid array, LGA)、四侧无引线扁平封装(quad flat no lead, QFN) 、嵌入式晶圆级球栅阵列 (embedded wafer level ball grid array, eWLB) 封装,以及基于低温共烧陶瓷 (low temperature co-fired ceramics, LTCC) 封装。将厚膜技术实现的天线阵列同射频芯片通过金丝键合封装到一个QFN封装里面 , 实现了中心频率122 GHz,带宽12 GHz,最大增益11.5 dBi的封装天线。图2是一种四单元有源阵列封装天线样品 , 中心频率10 GHz, 带宽4 GHz,单通道脉冲功率5W。
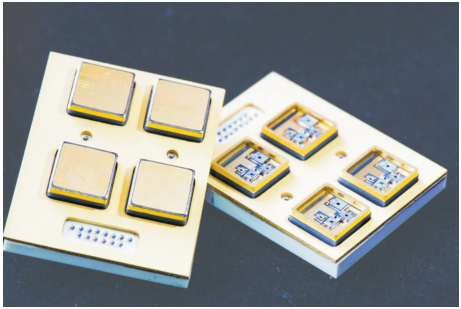
图2 (网络版彩图) 一种封装天线样品
SiP 采用绝缘衬底上的硅 (silicon-on-insulator, SOI) 工艺和QFN封装技术 ,将片上天线和封装天线相结合,在54.5∼63.4 GHz 的频率范围内 , 实现了最大8 dBi的天线增益。偶极子天线利用eWLB 封装内部的再分布层 (redistribution layer) 来实现 , 并在封装外部设计了一个介质透镜来提高天线增益,该天线在未安装透镜时的增益为5.9 dBi,安装上透镜后,增益提升到13.7 dBi。
瓦片式阵列天线的结构特点是多功能电路板同时作为封装外壳的主体,其往往不使用或很少使用高频、低频接插件。采用瓦片式阵列可以大幅度降低天线系统的厚度 , 极大减少连接器和电缆的使用数量。射频模块可选择商用微波封装和制造技术 , 进一步降低成本。这种瓦片式阵列架构采用工业标准的QFN封装 , 将有源电路层直接焊接在一个廉价印制电路板 (printed circuit board, PCB)上 , 然后再直接焊接到瓦片天线阵面的背部。瓦片式阵列天线如图3所示 。
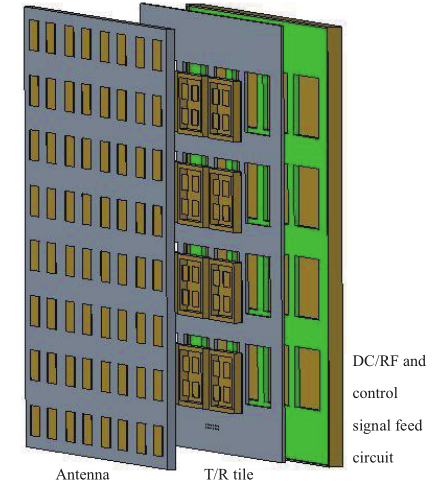
图3 (网络版彩图) 瓦片式阵列天线示意图
在集成电路后摩尔时代 , 亚微米、纳米技术的出现 , 给有源阵列天线技术的发展带来新的契机 , 一方面高效率、低剖面和轻量化大孔径阵列天线是微波成像雷达装备发展需求 , 具有重大军事应用前景 ;另一方面 , 天线阵列微系统将电子信息系统的微型化、多功能化、智能化、低功耗和可靠性水平提高到新的高度 , 对阵列天线技术的发展有着重要的促进作用 。
3.2 天线阵列微系统概念和内涵
未来有源阵列天线的形态界限将趋于模糊 , 天线将集成越来越多的有源和无源电路 , 朝着天线阵列微系统方向发展 , 但逻辑界限会越来越清晰 , 实现一体化是必然结果 . 随着网络信息体系的科学技术的不断深入 , 有源阵列天线势必向集成化、数字化、多功能一体化方向发展,如图 4 所示 , 将深刻影响到多平台高分辨率对地观测和宇宙探索等方方面面 。

图4 (网络版彩图) 未来的有源阵列天线
图 5 展示了常规有源相控阵天线与天线阵列集成系统两种构型的比较。图 5(a) 是工作在 9.6 GHz有源相控阵天线砖块式结构形式 , 天线厚度是 155 mm. 图 5(b) 和 (c) 分别是天线阵列集成系统的辐射面和背面 , 工作在 35 GHz, 瓦片式结构形式 , 天线厚度是 5 mm。如果按照天线阵列微系统的概念进行研究,还可以进一步提高集成度和性能参数 。

图5 (网络版彩图) 两种构型天线比较
天线阵列微系统是有源阵列天线发展的高级阶段,用较小的天线阵列微系统功能模块构建大型系统可能会更经济,这些天线功能模块可分开集成封装后再互连。天线阵列微系统定义为,以微纳尺度理论为支撑,以电磁场、微电子、光电子、材料和热力学为基础 ,结合体系架构和机电热多物理场模型,运用微纳系统集成技术和方法,将天线阵列、有源收发通道、功率合成 / 合成网络、频率源、波束控制和电源以及导热结构等三维异构混合集成在一个狭小的封装体里,如图 6 所示,互连线的大幅缩短,得到更小的插入损耗和更好的匹配性 。
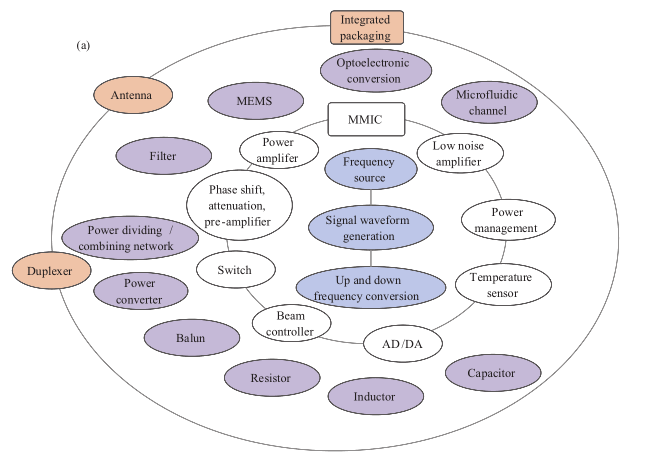
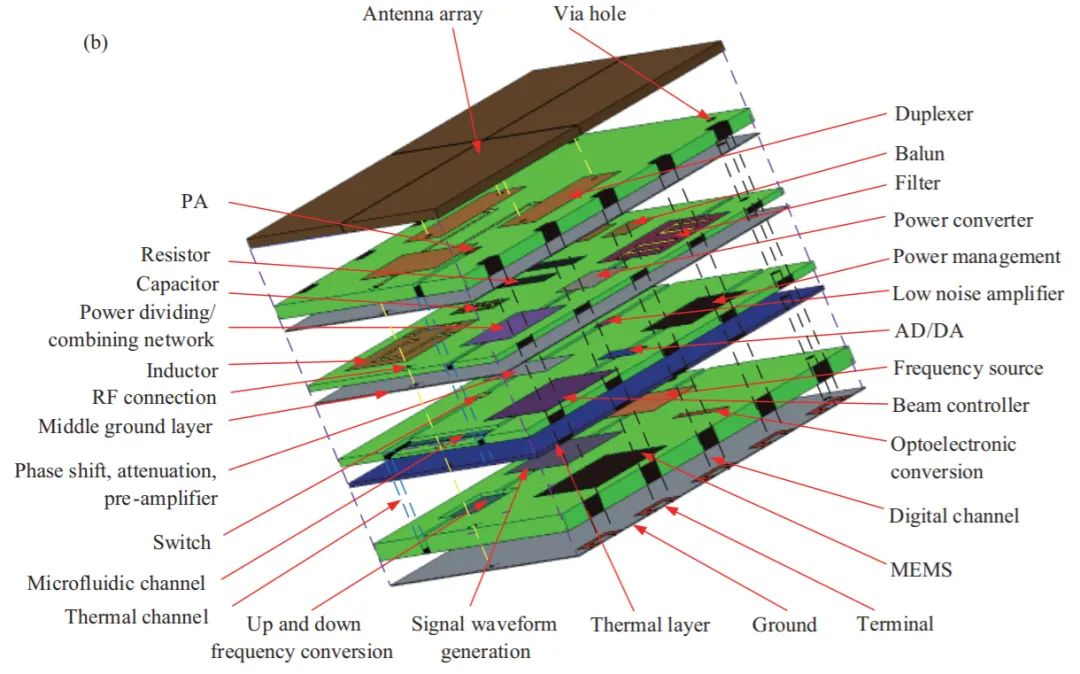
图6 (网络版彩图) 天线阵列微系统示意图
3.3 天线阵列微系统与常规微系统之间关系
微系统的概念随着相关学科发展、技术推动 , 以及应用需求的牵引 ,其内涵也在不断丰富和发展。早期,微系统 (microsystem) 概念在欧洲同行中使用,在美国被称为 MEMS,在日本被称为微机械 (micromachine) 。
1998 年,美国国防高级研究计划局 (The Defense Advanced Research Projects Agency, DARPA) 微系统技术办公室 (MTO) 从新的角度提出了微系统概念,微系统是融合体系架构、算法、微电子、微光子、 MEMS 等要素,采用新的设计思想、设计方法和制造方法,将传感、处理、执行、通信、能源等功能集成在一起,具有多种功能的微装置。DARPA 微系统概念超越了微机电系统 (MEMS) 的认识,为微系统多学科融合、微小尺度集成、军事应用创新和电子信息系统小型化及性能提升提供了空间,推动了微系统集成方法和技术的进步,2017 年,美国 DARPA 微系统办公室启动电子复兴计划 (ERI),分别在材料与集成、电路设计和系统构架等三大支柱领域布局六大发展项目 。
2007 年 ,欧盟在第 7 个科技框架计划下,设立了 “ 微推进器、可实现宇宙探索用高效和精确控制的化学微推进器 ” 等多个微系统项目。2014 年 , 启动了 “ 地平线 2020” 项目扶持微系统技术发展。日本依托其电子制造企业 , 在细分领域开展相关技术研究,索尼的图像传感器、东芝的 3D NAND 闪存都具有微系统产品的特征 。
我国已经陆续开展微系统相关技术的预先研究。国发 (2015) 28 号《中国制造 2025 》,将微系统技术作为提升新一代信息技术产业自主发展的重要能力 。国发 (2016) 43 号《 “ 十三五 ” 国家科技创新规划》中明确将 “ 微纳电子与系统集成技术 ” 作为新一代信息技术重点发展 。
从当前国内外研究来看,微系统是以微纳尺度理论为支撑,以微电子、光电子、 MEMS 等为基础 ,结合体系架构和算法 , 运用微纳系统集成技术和方法 , 将传感、通信、处理、控制、微能源等功能单元,在微纳尺度上采用异构、异质等方法集成在一起的微型系统 。
天线阵列微系统与常规微系统共同之处是都具有微型化、集成化、智能化等特点, 它们都区别于宏观系统的关键特征就是采用微纳尺度集成方式,尤其是三维异构混合集成,这不仅只是一个物理实现方式从平面式到立体式的变化,它们在体积重量大幅度缩小的同时,通过系统物理架构创新带来了功能 / 性能上的大幅提升,甚至能够实现宏观系统无法实现的功能。天线阵列微系统和常规微系统有一定的区别,常规微系统希望三维尺寸都能够缩减,使其达到最小体积和重量, 而天线阵列微系统通过三维异构集成技术,使天线阵列孔径尺寸不变的情况下 , 尽量减小天线的厚度和重量。为了满足电子信息系统大功率孔径积的需求,天线阵列微系统重点关注性能 ( 例如降低射频损耗等 ) 提升和天线剖面厚度的降低 ,实现大孔径阵列天线可折叠或者可共形,在体系架构和集成方式上有一定的特殊性 。
未来电子信息系统,例如微波成像雷达,将划分为两个物理单元,一是数字计算机单元 , 也就是通用信号处理机;二是天线阵列微系统 ,也就是由天线、收发组件、波束控制、电源、频率综合、接收机等传统分系统组成的微系统。天线阵列微系统的评价可以用两个因子来表述,效能因子 = 功率 × 孔径 × 带宽 ;尺度因子 = 功耗 × 体积 × 重量。效能因子的提高和尺度因子的降低是度量天线阵列微系统性能的重要指标 。
天线阵列微系统与传统有源相控阵天线在科学理论、仿真分析和设计制造等方法有很大区别 ,两者间的比较如表 2 所示。实现天线阵列微系统,需要解决两个方面的瓶颈问题,一是无源和有源电路芯片化或小型化;二是无源辐射天线单元, 或者多个辐射天线单元组成小型天线子阵列,与多种无源 / 有源电路三维异构混合高密度集成,形成为一个独立功能天线微系统封装体 。

表 2 天线阵列微系统与有源相控阵天线的比较图片


电磁现象和天线科学技术的进步是支撑经济社会发展和保障国家安全的战略性、基础性和先导性技术 , 承载着军事装备系统发展变革、信息系统智能化小型化、微电子技术革命性创新的发展使命。天线阵列微系统是有源阵列天线和微系统等科学技术的高度融合,面临的主要科学技术挑战如图 7所示 。

图7 (网络版彩图) 天线阵列微系统面临的科学技术挑战
4.1 多物理场约束下架构与拓扑技术
天线阵列微系统的架构突破了微电子技术范畴 , 无法在功能、性能上分割成简单单元 , 在力、光、材料、电子、信息等学科均有布局,实现了光、机、电、磁、声等各系统要素间的紧密关联。天线阵列微系统架构既有系统级的架构、性能、功能、算法等特征,又有元件级电、热、材料参数特性。天线阵列微系统架构在多物理场约束下跨学科、跨专业 , 学科、功能和性能界面的模糊性和交叉性 , 给天线阵列微系统研究带来很大困难,需要研究多物理场约束下架构与拓扑技术,重点是多物理场相互之间耦合机理、电磁特性模型,以及多维度参数容差分析与评价 。
4.1.1 多物理场耦合机理
大尺度天线与微小尺度芯片集成在同一封装体内,存在着大尺度天线辐射的电磁场与不同小尺度芯片微观的纠缠效应;射频信号与模拟、数字信号在封装体内的串扰效应 ; 射频信号在微观尺度下的趋肤效应等 , 需要研究多物理场耦合机理。以多物理场耦合为切入点 , 分析微小尺度下的射频集成、高密度异构、高精度变换、高速信号传输互连等的时域和频率耦合机理 , 指导系统指标的分解与优化 , 为构建合理有效天线阵列微系统架构和拓扑提供科学保证 。
通过提取天线阵列微系统架构中的光、机、电、磁、声等多元参量特征 , 结合热、流体、力学、电磁学等 ,开展多物理场在微小尺度下的耦合和互扰研究 , 以解决因多参量间的作用而相互约束问题 。
围绕射频、模拟和数字等复杂信号在三维微小尺度下的传输特征,从天线阵列微系统的可靠性、可制造性 (design for manufacturing, DFM) 解析,并不断迭代改进,重点解决天线阵列微系统的长期稳定性与可靠性,建立标准模型库,同时梳理机电热多物理场仿真标准流程 。
4.1.2 异构体电磁特性模型
在天线阵列微系统封装体内,三维微小尺度互连产生电磁场不连续性,造成了电磁场互扰、有害模式寄生辐射,引起天线极化失配、工作频带内 / 外隔离特性的变化。为了获得天线较好的工作带宽、高效率和低交叉极化等性能 ,需要在特定边界下,尤其是在宽带宽扫描角条件下 , 研究天线口径场模式匹配技术、阵列天线辐射单元之间的互耦特性 。
在微小尺度下,通过开展异构体电磁特性的研究分析 ,建立天线阵列微系统中各功能单元的电磁分布模型,并将模型应用于复杂的系统设计中 ,构建系统的多端口特性模型 。
通过分析内部复杂信号的传导变换、空间辐射及阻抗匹配等问题,开展三维电磁场提参建模与时频域分析,研究系统级功能单元、互连单元、封装单元模型,得到信号在异构体内传输变换时,三维多变量函数和超高速信号电磁特性模型库, 构建等效模型,解决电磁干扰、串扰误码等关键问题,并在此基础上优化天线阵列微系统中异质材料和功能异构体的分布,进一步得到电磁性能最优化的特性模型 。
4.1.3 多维度匹配容差适应性
大尺度情况下 ,微波传输线的不连续将产生高次模,高次模需要一定长度的传输线来衰减和消除。在微小尺度下,微波芯片与传输线互连、传输线与传输线互连等,既有平面的,也有立体的,使微波传输线的不连续点的数量大幅度增加,本征模的特性发生了变化,传输线上的工作模式将是主模和寄生效应产生的高次模并存。因此需要研究边界条件强约束下的激励模式匹配理论 , 仿真分析微小尺度互连产生寄生效应 。
针对微系统高密度封装中机、电、热等匹配带来的功能和性能适应性问题 ,以及工艺制造精度对器件和系统的影响问题,开展异质异构体多维度匹配适应性的研究,在此基础上形成天线阵列微系统异质异构体中 ,复杂信号传输和变换在多个维度 ( 包括机、电、热等 ) 上的容差评价 。
针对微系统多个维度上的参数偏差范围和寄生参数变量,进一步分析功能电路受其影响的机理、环节和效应。着重分析由于天线阵列微系统剖面厚度减小带来的功率密度加大 , 以及因热而产生的机械精度的变化 , 这些物理量进而又影响性能和功能。在兼容工艺条件下,建立影响复杂信号品质、多物理场耦合的多维度函数 , 实现基于不同功能的有源电路 / 无源元件 / 封装的系统集成。以此来指导微系统中三维异质异构体鲁棒性设计 。
4.2 微波集成电路技术
天线阵列微系统中包括了大量微波有源集成电路,并向着数字化方向发展。对于天线阵列微系统来说 , 低剖面、高效率和轻量化是非常重要的,必须有一个强大的微波集成电路技术为后盾 。
微波集成电路是指采用先进半导体工艺 , 以放大、变换、校准、比较和传输等手段处理微波 / 模拟信号的集成电路。随着微波集成电路和数字化技术的发展 , 微波芯片的集成度越来越高 , 集成电路将多个单功能芯片集成在一块芯片上 , 提高了芯片的性能并降低成本。微波单片可集成小信号接收链路和发射链路部分电路 , 接收链路包括低噪声放大器、混频、增益控制等 , 甚至包括高性能模拟 – 数字转换器 (analog-to-digital converter, ADC) 等,发射链路包括信号产生、混频、功率放大器等。不同的半导体材料具有不同的本征参数 , 有着不同的用途。几种半导体材料特征参数如表 3 所示。Si 通常用于数字 / 模拟控制或低波段功率芯片的基础材料 , GaAs 常用于 Ka 波段以下微波射频芯片基础材料。SiC, GaN 和金刚石 (diamond) 是第 3 代半导体材料 , 可以具有宽禁带 (WBG) 特点 。
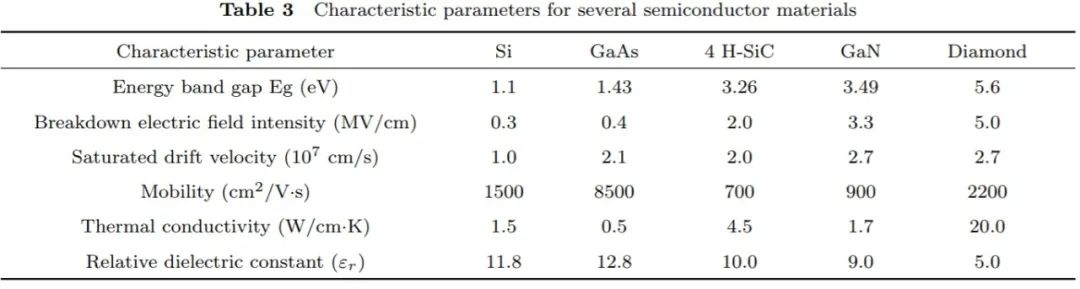
表 3 几种半导体材料特征参数图片
摩尔定律正逼近物理极限,芯片性能提升的放缓和数据需求几何级数式的增长之间矛盾将日益凸显 , 5 nm 技术的推进中 , 面临着来自晶体管的结构、掩模版的制造等方面的技术瓶颈。这也意味着 5 nm 技术节点的突破 , 将会使得集成电路技术发展面临一系列的新技术挑战。在 SoC 减少特征尺寸 ( 比例缩小 ) 已经越来越难 , 而且成本很高。半导体集成电路重要的发展趋势是新型微波、低功耗和智能控制等异质多功能集成电路 。
4.2.1 第 3 代半导体集成电路技术
在微波单片集成电路技术中 , 以氮化镓 (GaN) 为代表的第 3 代半导体技术 , 因其宽禁带特性 , 具有高功率密度、高功率附加效率、高增益、大带宽和小尺寸 , 及较高的可靠性和工作温度 , 已用于相控阵雷达 , 将会对天线阵列中的射频前端产生革命性的影响。硅基 GaN 异质集成可以取得新的、以前无法实现的新的集成电路架构 , 以达到提高性能、提高可靠性 , 以及降低成本。第 3 代半导体集成电路技术的发展 , 将促进天线阵列微系统单通道发射功率和效率的提高 。
4.2.2 多功能 / 低功耗集成电路技术
在半导体外延材料技术和微波单片集成电路工艺不断进步的推动下 , 微波单片集成电路逐渐向多功能方向发展 , 由于多功能芯片的不同功能电路之间的互连已在内部完成 , 焊点数量大大减少 , 可大幅度缩减芯片体积 , 降低成本 , 提高集成一致性和可靠性。例如微波收发多功能芯片可以将放大器、移相器、开关、衰减器等集成在一个芯片内 , 替代传统单功能芯片。由于多功能芯片的制造大多还没有专门的工艺平台 , 对于发射功率较小的情况 , 采用低噪声工艺实现 , 而功率较大时可采用功率工艺实现,所以接收或发射性能可能不能同时达到最佳状态 , 接收和发射链路的设计要素常常彼此冲突 , 因此在接收和发射性能平衡兼顾下 , 进行最优化设计是研究难点 。
低功耗集成电路的实质就是在集成电路的基础上 , 将整个电路系统的能耗降至最低 , 需要解决高K/ 金属栅技术、高迁移率沟道材料和超低亚阈值斜率器件等关键技术 , 而要想实现超低功耗集成电路 ,就需要从电路材料的选择、内部元件排列、电源硬件设计 , 以及系统能耗的控制等技术方面进行研究 。
4.2.3 智能控制集成电路技术
以天线阵列微系统体系架构需求为导向 , 基于软件可定义、硬件可重构的要求 , 开展基于 IP 模块的 SOC, 专用集成电路 (application specific integrated circuits, ASIC) 等多功能芯片研究和设计 , 突破IP 核复用技术、低功耗设计技术、可测试性技术等。同时根据天线阵列微系统微小尺度下多物理量耦合、多功能集成等特点 , 开展适配的软件算法的研究,重点解决天线阵列微系统软硬件协同设计的难题 。围绕天线阵列微系统的功能增强和异构工艺适配开展芯片设计研究 , 优化控制策略 , 实现智能数字控制 , 降低系统功耗 , 突破海量数据实时处理、超高频、超高速和超大容量数据通信 , 以及高效热能量传递的技术瓶颈 , 并完善内部辅助功能和保护功能 , 实现接口标准化 , 提高天线阵列微系统硬件和软件的整体适用性和兼容性 。
4.3 多物理场匹配混合集成技术
混合集成电路 (hybrid integrated circuit, HIC) 技术是采用厚 / 薄膜技术、微组装技术和封装技术将半导体芯片、无源元件等集成于一体来实现既定功能和性能 , 是实现天线阵列微系统的重要途径之一。图 8 是单片集成和混合集成关系示意图 , 单片集成是永恒的追求 , 混合集成是单片集成的二次集成。混合集成技术涉及到一个复杂的多层次多专业的技术体系 , 可以分为架构设计技术、多层互连基板技术、微互连技术、高气密性封装技术 , 以及可靠性评估与应用等一系列的基础理论、制造实践和应用技术 。
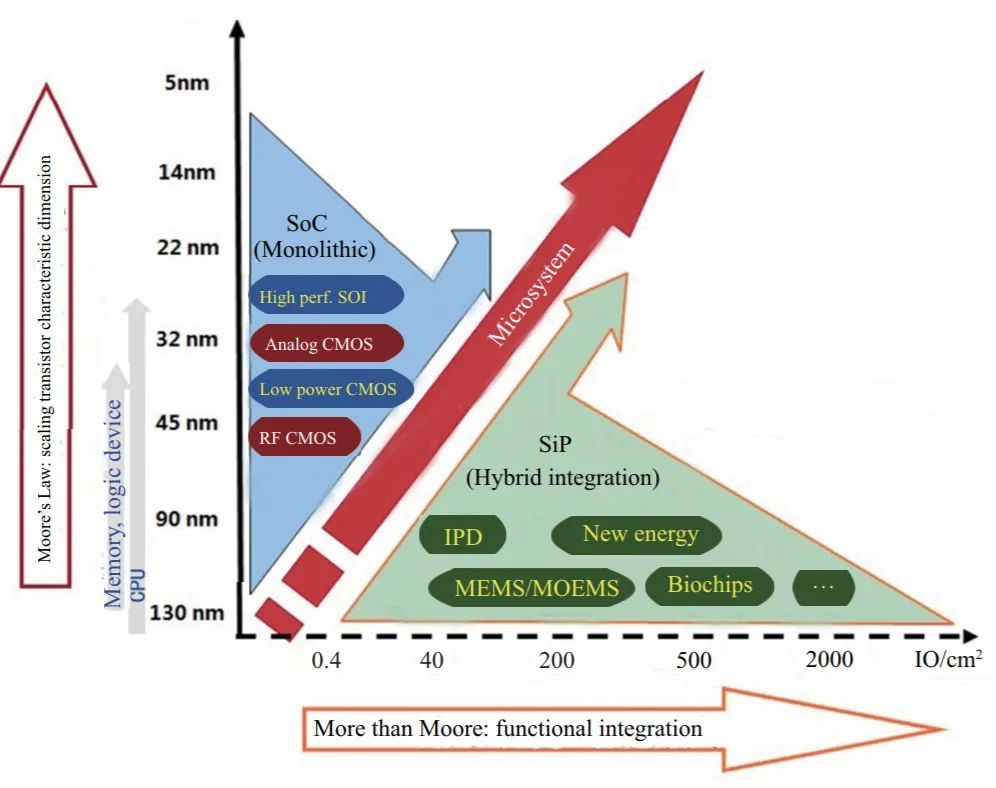
图8 (网络版彩图) 混合集成与单片集成
多物理场匹配混合集成技术研究是天线阵列微系统小型化、轻量化、高密度、多功能的需求 , 基于电、光、磁、力等多物理场维度下的混合集成前沿性共性技术研究 , 重点突破 2.5D/3D 垂直互连、三维异质异构微组装和高密度异质多层基板等技术 , 解决天线阵列微系统中电磁兼容、高速信号传输与串扰、热管理、应力匹配、光电干涉等技术难题 。
混合集成技术的演进经历过四大变革 , 即通孔插装技术向表面安装技术的变革 , 周边互连到面阵互连的变革 , 单芯片向多芯片的变革 , 二维结构向三维结构的变革。正是这些变革使许多新型混合集成技术不断涌现 , 组装效率不断提高 , 推动混合集成电路向 “ 四高一小一轻 ” 方向不断发展 . “ 四高 ” 是高组装密度、高频、高功率密度、高可靠 ; “ 一小 ” 是体积更小 ; “ 一轻 ” 是重量减轻 。
4.3.1 2.5D/3D 垂直互连技术
2.5D/3D 垂直互连技术基于多学科多专业, 融合了系统设计和微纳集成工艺 , 以实现不同材料、不同结构、不同工艺、不同功能元器件的三维异构集成,是以突破摩尔定律极限为目的, 重点解决天线阵列微系统内部高速、高频、大功率传输下的超高密度互连难题 。2.5D/3D 互连通过基材过孔金属化垂直互连技术和凸点技术进行电气垂直互连。通过研究各种复合材料导体及介质对复杂信号的传输与屏蔽适应性和匹配性影响,解决微系统中可能出现的串扰、延迟、能耗等难点。同时, 在工艺研究时 , 充分考虑热力学和电性能的参数匹配,避免不同材料之间的热失配和机械应力 。
代表性的叠层型 3D 封装可以是裸芯片的叠堆,MCM 的叠层甚至还可以是晶圆片的堆积。3D 先进封装典型结构如图 9 所示。3D-MCM 可以将不同工艺类型的芯片 ( 如模拟、数字和射频等功能芯片 ) 在单一封装结构内实现混合信号的集成化 , 在满足天线阵列微系统模块机械性能要求 , 以及在模块尺寸、重量及功耗极端受限的情况下 , 通过对多功能电路转接板厚度进行最优化设计 , 可以减小天线阵列微系统封装体的厚度 , 并进一步提高集成密度 . 3D 硅片集成的核心是硅通孔 (TSV) 技术 , 用于互连堆叠的芯片 , 从而增强性能 , 缩短信号传输时间 , 解决信号延迟等问题。
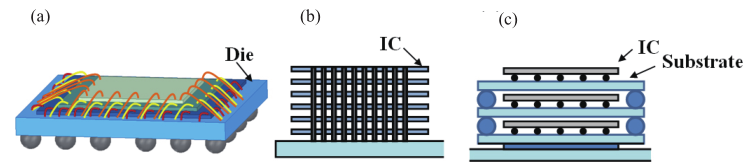
图9 (网络版彩图) 3D 先进封装典型结构示意图
4.3.2 三维异质异构微组装技术
异质芯片集成扇出型技术是有别于片上系统和晶圆级封装的先进技术 , 重点通过晶圆再造和再布线技术实现异质芯片的集成 , 解决异质芯片间的高密度互连 , 是实现天线阵列微系统功能模块集成的关键技术 。
采用异质芯片集成扇出型技术是通过半导体先进工艺 , 将不同光、电、磁等功能的异质芯片整合集成再造成一个晶圆 , 并通过薄膜高密度布线 , 形成具有多功能芯片的集成技术 . 可以达到减小天线阵列微系统功能模块厚度和体积的要求 . 异质芯片扇出晶圆级封装 (FOWLP) 厚度小、成本低 , 不需要基板 , 不需要在晶圆上打凸点、回流倒装焊以及助焊剂清洗 , 改善了电性能和热性能 , 更易于系统级封装。
三维异构微组装技术是在多学科系统设计和微纳集成制造工艺的基础上 , 实现不同材料、结构、功能元件的一体化三维异构混合集成 , 解决异构材料的机电、热、力等失配、同时解决并完善系统功能的新型微组装技术 。
从科学研究的层面 , 需要研究半导体工艺的局限性及混合集成的攻关方向 , 例如 , 哪些类芯片、结构体、材料可以进行混合集成 , 哪些类不行 , 并提炼出普适性规律与方法 .从技术研究的层面 , 是在系统架构的基础上 , 通过微焊互连和微封装等混合集成技术 , 将高集成度的 IC 器件、微结构及其他元器件三维组装到封装体内 , 构成高密度、高可靠天线阵列微系统功能模块 , 是实现芯片功能到系统功能的桥梁 。
4.3.3 高密度异质多层基板技术
天线阵列微系统的研究通常是基于三维异构混合集成技术 , 典型是多芯片组件 (MCM) 和系统级封装 (SiP) 技术。进一步来说 , 以上技术大多数都是采用叠层型 (MCM-L) 、沉积薄膜型 (MCM-D) 和共烧陶瓷型 (MCM-C) 互连基板技术。
高密度异质多层基板研究是将基板制备技术、膜集成技术 , 通过多层基板协同设计和多物理场耦合分析 , 采用合理的工艺方法进行匹配兼容 , 可制备内置阻容元件和感性元件的高密度无源集成异质多层基板或集成无源器件 (integrated passive device, IPD). 厚薄膜无源元件集成基板技术是采用先进微电子技术和材料 , 在 LTCC 多层基板内置电阻、电容、电感等元件 , 如图 10 所示 , 可缩短分立器件的互连长度 , 降低寄生效应 , 减少互连焊点 , 同时有利于解决多径衰弱、频谱拥挤、噪声干扰等系统问题 。
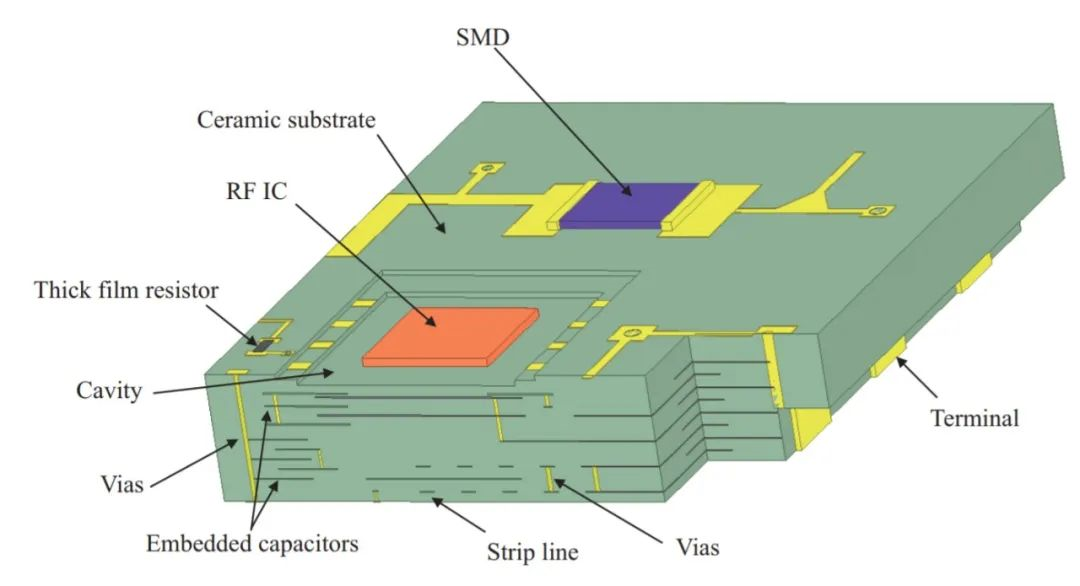
图10 (网络版彩图) 基于 LTCC 多层基板内置无源元件集成示意图
混合多层基板是两种或两种以上不同材质的基板集成制作为多层基板 , 基于不同材质基板的物理参数和特性 , 进一步提高多层基板的性能和布线密度、组装效率 , 降低成本。例如 , 共烧陶瓷 / 薄膜型混合基板 , 其中薄膜多层基板可布置高速信号线、接地线和焊接区 , 充分利用薄膜多层布线的信号传输延迟小、布线密度高的特性 , 共烧陶瓷基板上布置电源线、接地线或低速信号线 , 充分利用它易于实现较多布线层数和适宜于大电流的特性。
4.4 封装与热管理技术
极大功能化、微纳尺度、多尺度结构、多类型材料 , 以及有源和无源嵌入式厚薄膜元件是实现天线阵列微系统的重要特征。随着天线阵列微系统向小型化、高性能和高密度集成的发展 , 多功能器件( 例如 GaN, SoC 芯片 ) 的功耗不断增大 , 芯片散热已经从小规模集成电路的几百毫瓦发展到上百瓦 .这些将导致功率芯片及无源元件等成为非均匀分布的热源 , 提升了热流密度 . 封装的目的是为天线阵列微系统提供散热通道 , 还为内部芯片、元件和基板提供机械支撑、密封保护和内外信号互连等 . 热管理的目的是通过多种方法导出热量 , 使封装体内温度维持在允许的范围内 , 避免天线阵列微系统内部温度的逐渐升高 , 超过限定值 , 引起键合材料的蠕变、掺杂物的扩散、器件应力上升、结构破坏等现象 , 导致天线阵列微系统停止工作或丧失其功能 。
4.4.1 多本征参数适配材料技术
多本征参数适配材料技术重点研究围绕基板、布线、框架、互连导体、层间介质、密封材料和封装外壳等功能材料 , 针对金属、陶瓷、聚合物基复合材料、金属基复合材料、陶瓷基复合材料以及多种增强体和材料本体结合 , 制备出的复合功能材料 , 例如 , 铝硅、铝碳化硅复合材料 , 满足天线阵列微系统封装轻量化、小型化、低损耗、高导热等要求 。
针对天线阵列微系统封装小型化和多功能化的需求 , 新型基板材料、导体浆料、基板制备技术、膜集成技术的搭配和融合技术 , 是实现高密度异质多层基板技术的基础。例如 , 中温瓷填孔钨铜浆料技术可实现高速 DSP 信号传输 ; 单芯片扇出技术可实现高密度微小间距芯片与陶瓷基板的互连 ; 氮化铝填铜柱垂直互连技术可实现大电流传输 , 同时满足大功率器件散热需求。随着宽禁带 (WBG) 半导体技术大规模商业化的来临 , 研发新的封装材料和技术迫在眉睫。
4.4.2 嵌入式热管理技术
基于微纳技术的冷却器在常规微系统热管理中发挥了日益重要的关键作用 , 目前电子系统的散热已经由传统的自然对流、金属导热和强制风冷散热发展到液冷和热管散热 , 液冷散热方式中的微流道散热是天线阵列微系统的有效和方便的散热方式。例如 , 利用 LTCC 技术制作的嵌入式微流道液冷基板 , 具有体积小、散热面积大、功率消耗低、批量制作成本低等特点。流道冷却器吸收芯片上的热量 , 通过液体循环将热量传给外界 , 达到散热的目 。LTCC 内嵌 3D 微流道系统分为多排直槽型、蜿蜒型和分形流道。一种典型的 3D 微流道结构示意图如图 11 所示。利用 LTCC 单张生瓷片可分别加工的优势 , 用冲孔工艺在单张 LTCC 生瓷片上制作二维微流道 , 将所有生瓷片叠片、热压、烧结 , 形成完整的 3D 微流道 。
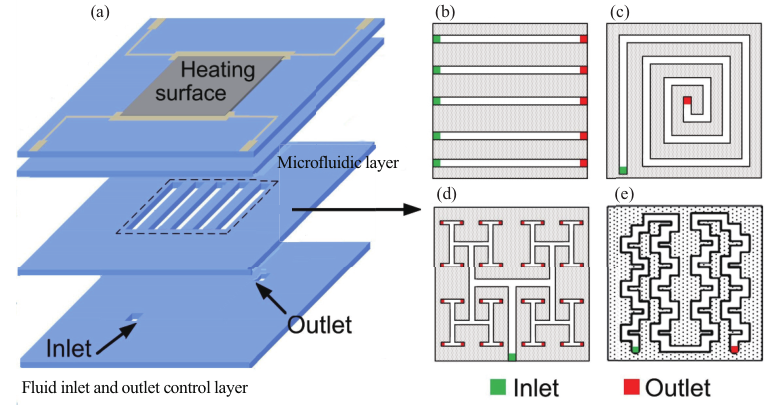
图11 (网络版彩图) LTCC 内嵌 3D 微流道结构示意图
4.4.3 陶瓷金属一体化封装技术
陶瓷金属一体化封装技术 (integral substrate package, ISP) 是将多层基板作为封装的载体 , 与封装外壳腔壁相连 , 多层布线基板构成外壳整体的一部分 , 在基板上直接引出封装的外引线 , 是一种气密性封装 , 不需要再用全金属外壳封装。根据环境、结构、尺寸等边界条件 , 开展温度场分布及不同条件对温度场的影响、热阻与散热路径、机械承载与结构应力、电磁场等微结构分析与优化。在提高了封装密度 , 降低了封装体厚度 , 减轻了重量的同时 , 一体化封装技术也有益于微波信号传输和热管理 。例如 , 一种典型基于 LTCC 工艺的三维异构混合集成是将两个金属 / 陶瓷模块通过一块金属转接板相互连接在一起。


技术创新在一定程度上取决于预测技术方向及它在未来的应用发展方向 , 并敢于相信那种直觉 。后摩尔时代 , 天线阵列微系统的研究和发展 , 需要解决两个非常重要的核心问题 : 一是发展摩尔定律,实现芯片性能进一步提升 , 三维异质集成能够超越摩尔定律 ; 二是实现后摩尔定律追求的多功能三维异构集成 , 实现系统性能和能力的提升。未来的天线阵列微系统将在体积与重量、性能、效率 , 以及智能化水平方面取得巨大进步 , 必将大大推动下一代更高性能微波成像雷达问世 。
本文针对星载及机载平台需求,设计了一种L波段低剖面、轻量化、维修性高的相控阵天线单元,实现了E面扫描±60°,H面扫描±20°的宽角扫描,效率高于83%,具有良好的工程可实现性。

参考文献:
1 Lu J G. Design Technology of Synthetic Aperture Radar. Hoboken: Wiley, 2019
2 Wang W, Lu J G, Zhang H T, et al. A brief review of SAR antenna development in China. In: Proceedings of IEEE International Conference on Radar, Guangzhou, 2016
3 Lu J G. Design Technology of Synthetic Aperture Radar. Beijing: National Defense Industry Press, 2017 [鲁加国. 合成孔径雷达设计技术. 北京: 国防工业出版社, 2017]
4 Lu J G, Wang W, Lu X P, et al. Three matching problems in waveguide slot antenna research. Radar Sci Technol,2012, 18: 115–123 [鲁加国, 汪伟, 卢晓鹏, 等. 波导缝隙天线研究中的 “三匹配” 问题. 雷达科学与技术, 2020, 18:115–123]
5 Lu J G. The technique challenges and realization of space-borne digital array SAR. In: Proceedings of the 5th AsiaPacific Conference on Synthetic Aperture Radar (APSAR), 2015
6 Zhang Y P, Sun M, Guo L H. On-chip antennas for 60-GHz radios in silicon technology. IEEE Trans Electron Device,2005, 52: 1664–1668
7 Kang K, Lin F, Pham D D, et al. A 60-GHz OOK receiver with an on-chip antenna in 90 nm CMOS. IEEE JSolid-State Circ, 2010, 45: 1720–1731
8 Ojefors E, Sonmez E, Chartier S, et al. Monolithic integration of a folded dipole antenna with a 24-GHz receiver in SiGe HBT technology. IEEE Trans Microw Theory Tech, 2007, 55: 1467–1475
9 Ojefors E, Kratz H, Grenier K, et al. Micromachined loop antennas on low resistivity silicon substrates. IEEE Trans Antenna Propag, 2006, 54: 3593–3601
10 Babakhani A, Guan X, Komijani A, et al. A 77-GHz phased-array transceiver with on-chip antennas in silicon: receiver and antennas. IEEE J Solid-State Circ, 2006, 41: 2795–2806
11 Zhang Y P. Integration of microstrip antenna on ceramic ball grid array package. Electron Lett, 2002, 38: 207–208
12 Chang K F, Li R, Jin C, et al. 77-GHz automotive radar sensor system with antenna integrated package. IEEE Trans Compon Packag Manufact Technol, 2014, 4: 352–359
13 Shen T M, Kao T Y J, Huang T Y, et al. Antenna design of 60-GHz micro-radar system-in-package for noncontact vital sign detection. Antenna Wirel Propag Lett, 2012, 11: 1702–1705
14 Pfeiffer U R, Grzyb J, Liu D X, et al. A chip-scale packaging technology for 60-GHz wireless chipsets. IEEE Trans Microw Theory Tech, 2006, 54: 3387–3397
15 Grzyb J, Liu D X, Gaucher B. Packaging effects of a broadband 60 GHz cavity-backed folded dipole superstrate antenna. In: Proceedings of Antennas and Propagation Society International Symposium, 2007. 4365–4368
16 Beer S, Gulan H, Rusch C, et al. Coplanar 122-GHz antenna array with air cavity reflector for integration in plastic packages. Antenna Wirel Propag Lett, 2012, 11: 160–163
17 Zevallos Luna J A, Dussopt L, Siligaris A. Hybrid on-chip/in-package integrated antennas for millimeter-wave shortrange communications. IEEE Trans Antenna Propag, 2013, 61: 5377–5384
18 Tong Z Q, Fischer A, Stelzer A, et al. Radiation performance enhancement of E-band antenna in package. IEEE Trans Compon Packag Manufact Technol, 2013, 3: 1953–1959
19 Kuo J L, Lu Y F, Huang T Y, et al. 60-GHz four-element phased-array transmit/receive system-in-package using phase compensation techniques in 65-nm flip-chip CMOS process. IEEE Trans Microw Theory Tech, 2012, 60: 743–756
20 Javid B, Heydari P. Design and implementation of a CMOS 4-Bit 12-GS/s data acquisition system-on-chip. IEEE Trans VLSI Syst, 2014, 22: 2164–2175
21 Fischer A, Tong Z, Hamidipour A, et al. 77-GHz multi-channel radar transceiver with antenna in package. IEEE Trans Antenna Propag, 2014, 62: 1386–1394
22 Hasch J, Topak E, Schnabel R, et al. Millimeter-wave technology for automotive radar sensors in the 77 GHz frequency band. IEEE Trans Microw Theory Tech, 2012, 60: 845–860
23 Gupta K C, Hall P S. Analysis and Design of Integrated Circuit-Antenna Modules. New York: Wiley, 2000
24 Baggen L, Holzwarth S, Boettcher M, et al. Advances in phased array technology. In: Proceedings of the 3rd European Radar Conference, 2006. 87–91
25 Baggen L, B¨ottcher M, Otto S, et al. Phased array technology by IMST. J IEEE, 2012, 4: 21–28
26 Lu J G, Wu M Q. Active phased array antenna based on DDS. In: Proceedings of IEEE International Symposium on Phased Array Systems and Technology, 2003. 511–516
27 Wang Z Y. Microsystem Design and Fabrication. Beijing: Tsinghua University Press, 2008 [王喆垚. 微系统设计与制造. 北京: 清华大学出版社, 2008]
28 Zhang W, Zhang D C, Wang Y Y. MEMS overview and trend. Micro Nano Electron Technol, 2002, 1: 22–27 [张威,张大成, 王阳元. MEMS 概况及发展趋势. 微纳电子技术, 2002, 1: 22–27]
29 The Research Center for Development and Strategy of CETC. Annual Development Report of World Military Electronics 2018. Beijing: Electronics Industry Publishing House, 2019. 1208 [中国电子科技集团公司发展战略研究中心. 世界军事电子年度发展报告 2018. 北京: 电子工业出版社, 2019. 1208]
30 Moore G E. Cramming more components onto integrated circuits. Electronics, 1965, 38: 3
31 Lau J H, Li M, Li Q Q, et al. Fan-out wafer-level packaging for heterogeneous integration. IEEE Trans Compon Packag Manufact Technol, 2018, 8: 1544–1560
32 Laroche J, Anderson K. Heterogeneous integration for RF & mixed signal system. In: Proceedings of Electronics Resurgence Initiative Summit, 2019. 126–151
33 Santagata F, Sun F W. System in package (SiP) technology: fundamental, design and applications. Microelectron Int,2018, 4: 231–243
34 Su Y F, Chiang K N, Liang S Y. Design and reliability assessment of novel 3D-IC packaging. J mech, 2017, 33: 193–203
35 Lau J H, Li M, Li Q M, et al. Design, materials, process, fabrication, and reliability of fan-out wafer-level packaging.IEEE Trans Compon Packag Manufact Technol, 2018, 8: 991–1002
36 Merkle T, Gotzen R, Choi J Y, et al. Polymer multichip module process using 3-D printing technologies for D-band applications. IEEE Trans Microw Theory Tech, 2015, 63: 481–493
37 Yang B C, Zhang J G. Multichip Module (MCM) Technology and Application. Chengdu: Electronics Science and Technology Publishing House, 2001 [杨邦朝, 张经国. 多芯片组件 (MCM) 技术及其应用. 成都: 电子科技大学出版社, 2001]
38 Keim T. Power electronics packaging rises to new challenges. IEEE Power Electron Mag, 2019, 4: 12–14
39 Mu F Q, Zhang Y F. Research on three dimensional microfludic system technology. J Chinese Electron Sci Res Acad,2011, 6: 20–23 [沐方清, 张杨飞. 三维微流道系统技术研究. 中国电子科学研究院学报, 2011, 6: 20–23]
40 Di Carlofelice A, de Paulis F, Fina A, et al. Compact and reliable T/R module prototype for advanced space active electronically steerable antenna in 3-D LTCC technology. IEEE Trans Microw Theory Tech, 2018, 66: 2746–2756
>End
本文转载自“网信前沿观察”“《中国科学: 信息科学》” 作者:鲁加国、王岩,原标题《后摩尔时代 , 从有源相控阵天线走向天线阵列微系统》。
为分享前沿资讯及有价值的观点,太空与网络微信公众号转载此文,并经过编辑。
支持保护知识产权,转载请注明原出处及作者。
部分图片难以找到原始出处,故文中未加以标注,如若侵犯了您的权益,请第一时间联系我们。
>>>
充满激情的新时代,
充满挑战的新疆域,
与踔厉奋发的引领者,
卓尔不群的企业家,
一起开拓,
一起体验,
一起感悟,
共同打造更真品质,
共同实现更高价值,
共同见证商业航天更大的跨越!
——《卫星与网络》,观察,记录,传播,引领。
>>>
· 《卫星与网络》特别顾问:王兆耀
· 《卫星与网络》编辑委员会
高级顾问:王国玉、吴炜琦、刘程、童旭东、相振华、王志义、杨烈
编辑委员:曹志刚、陈嵩辉、邓中亮、荆继武、景贵飞、郎燕、刘进军、刘天雄、宁振波、秦智、汪春霆、吴季、徐小舒、阎丽娟、赵敏、肇启明、周建华、朱铎先
· 《卫星与网络》创始人:刘雨菲
· 《卫星与网络》副社长:袁鸿翼
· 《卫星与网络》常务副社长:冉承新
